据媒体报道,自8月份以来,受游戏机、笔记本电脑和其他消费电子产品的需求增加影响,全球封测厂龙头日月光、力成科技等厂商的消费逻辑芯片封测订单明显增加,部分生产线已经满负荷运行。
由于消费逻辑芯片的订单增加,部分后端厂商三季度的月产能预计环比会增长20%到25%。
作为集成电路产业链不可缺少的一部分,半导体封测得益于对更高集成度的需求,以及5G、消费电子、物联网等驱动,市场规模快速扩大。
根据中国半导体协会数据,2019年我国半导体封测市场达2350亿元,同比增长7.10%。2012年我国封测市场销售额为1036亿元,七年以来我国半导体封测市场年复合增速为12.4%,增速保持较高水平。
封测作为我国半导体领域优势最为突出的子行业,在当前国产半导体产业链中,国产化程度最高、行业发展最为成熟。
随着上游的芯片设计公司选择将订单回流到国内,具备竞争力的封测厂商将实质性受益。随着5G应用、AI、IoT等新兴领域发展,我国封测行业仍然有望保持高增长。
集成电路封装测试是半导体产业链的中下游,包括封装和测试两个环节。
封装是对制造完成的晶圆进行划片、贴片、键合、电镀等一系列工艺,以保护晶圆上的芯片免受物理、化学等环境因素造成的损伤,增强芯片的散热性能,以及将芯片的I/O端口引出的半导体产业环节。
而测试主要是对芯片、电路等半导体产品的功能和性能进行验证的步骤,其目的在于将有结构缺陷以及功能、性能不符合要求的半导体产品筛选出来,以确保交付产品的正常应用。
其中,封装环节价值占比约为80%~85%,测试环节价值占比约15%~20%。
全球集成电路企业主要分为两类,一种是涵盖集成电路设计、制造以及封装测试为一体的垂直整合型公司(IDM公司),例如三星、英特尔、海力士等独立专业化的公司。
另外一种则是将IDM公司进行拆分形成独立的公司,可以分为IC设计公司、晶圆代工厂及封装测试厂。全球知名封装测试厂包括安靠、日月光、长电科技、通富微电等。
封测环节是半导体细分领域国产化进展最快的环节。国内企业最早以封测技术为切入点进入集成电路产业,近年来,国内封测企业通过外延式扩张获得了良好的产业竞争力,技术实力和销售规模已进入世界第一梯队。
在芯片制造产能向大陆转移的大趋势下,大陆封测企业近水楼台,抢占了中国台湾、美国、日韩封测企业的份额。国内的几家封测厂商长电科技、华天科技、通富微电等巨头都已经挤进全球前十名。
长电科技联合产业基金、芯电半导体收购新加坡封测厂星科金朋,获得SiP、WLP、FC+Bumping能力以及扇出型封装技术,技术达到国际一流水平,主要掣肘在于客户资源。
其规模进一步提升,目前已经做到全球第三名,同时在封测产品的布局上也进一步完善,在低端、中端、高端等封装领域都有突破。
华天科技收购美国FCI,通富微电联合大基金收购AMD苏州和槟城封测厂,晶方科技则购入英飞凌智瑞达部分资产。
全球十大封测厂通过这一系列并购后已经基本形成了日月光-矽品科技、安靠-J-Devices、长电科技-星科金朋等三大阵营。
全球封装技术的主流处于第三代的成熟期,向第四阶段演进。
SiP和3D是封装未来重要的发展趋势,但鉴于3D封装技术难度较大、成本较高,SiP,PoP,HyBrid等封装仍是现阶段业界应用于高密度高性能系统级封装的主要技术。
在最高端技术上制造、封测已有融合:台积电已建立起CoWoS及InFO两大先进封测生态系统。日月光拥有FC+Bumping等成熟技术。
先进封装技术将推动半导体封装市场继续扩容。集成电路封装技术的演进主要为了符合终端系统产品的需求,为配合系统产品多任务、小体积的发展趋势,集成电路封装技术的演进方向即为高密度、高脚位、薄型化、小型化。
根据麦姆斯咨询援引Yole预测,2019年-2024年期间先进封装市场预计将以8%的复合年增长率增长,市场规模到2024年将达到440亿美元;与此同时,传统封装市场的复合年增长率预计仅为2.4%。
海通证券认为,全球集成电路产业为降低生产成本而将生产中心转移至亚洲地区,在完整的、动态的垂直分工体系下,技术、品质及交期均有保障;而且随着IDM公司逐步增加部分测试业务的外包,集成电路测试代工业务将朝着专业化、高品质服务方向不断发展。
目前全球IC测试代工产业是封测一体厂和专业测试厂并存的格局,其中专业测试厂龙头厂商稳健成长。
集成电路封装与测试pdf
随着集成电路的高集成化、多功能化,促使引线框架向多脚化,小间距化、高导电率和高散热性发展,集成电路采用GBA、CSP封装方式发展速度很快,应是未来发展趋势。
但是由于市场的多样性,目前国内集成电路封装90%以上仍采用引线键合方式,引线框架需求仍然快速增长,尤其是SOP/TSOP、QFP等产品,仍是未来5~10年需求最大的产品,尤其是国内市场。
集成电路封装在电子学金字塔中的位置既是金字塔的尖顶又是金字塔的基座。
说它同时处在这两种位置都有很充分的根据。
从电子元器件(如晶体管)的密度这个角度上来说,IC代表了电子学的尖端。
但是IC又是一个起始点,是一种基本结构单元,是组成我们生活中大多数电子系统的基础。
同样,IC不仅仅是单块芯片或者基本电子结构,IC的种类千差万别(模拟电路、数字电路、射频电路、传感器等),因而对于封装的需求和要求也各不相同。
虽然IC的物理结构、应用领域、I/O数量差异很大,但是IC封装的作用和功能却差别不大,封装的目的也相当的一致。
作为“芯片的保护者”,封装起到了好几个作用,归纳起来主要有两个根本的功能:1)保护芯片,使其免受物理损伤;2)重新分布I/O,获得更易于在装配中处理的引脚节距。
封装还有其他一些次要的作用,比如提供一种更易于标准化的结构,为芯片提供散热通路,使芯片避免产生α粒子造成的软错误,以及提供一种更方便于测试和老化试验的结构。
封装还能用于多个IC的互连。
可以使用引线键合技术等标准的互连技术来直接进行互连。
或者也可用封装提供的互连通路,如混合封装技术、多芯片组件(MCM)、系统级封装(SiP)以及更广泛的系统体积小型化和互连(VSMI)概念所包含的其他方法中使用的互连通路,来间接地进行互连。
随着微电子机械系统(MEMS)器件和片上实验室(lab-on-chip)器件的不断发展,封装起到了更多的作用:如限制芯片与外界的接触、满足压差的要求以及满足化学和大气环境的要求。
人们还日益关注并积极投身于光电子封装的研究,以满足这一重要领域不断发展的要求。
最近几年人们对IC封装的重要性和不断增加的功能的看法发生了很大的转变,IC封装已经成为了和IC本身一样重要的一个领域。
这是因为在很多情况下,IC的性能受到IC封装的制约,因此,人们越来越注重发展IC封装技术以迎接新的挑战。


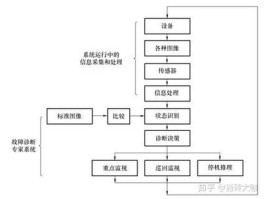







还没有评论,来说两句吧...